
該款新產品是佳能半導體光刻機產品線中,首個可對應大型方形基板的面向后道工序的光刻機。該產品配備佳能自主研發的投影光學系統,在實現大視場曝光的同時,還能達到1.0微米的高解像力。因此,在使用可降低數據中心CPU或GPU等能耗的有機基板的PLP4封裝工藝中,新產品將可以實現使用515×510mm大型方形基板進行高效生產的用戶需求。由于該產品具有高解像力、大視場曝光性能以及高產能,因此在實現半導體封裝5的進一步細微化和大型化的同時,還可以降低成本。

■ 可滿足高產能大型基板的封裝需求
為了滿足使用方形基板進行封裝工藝的需求,佳能開發了可以搬送515×510mm大型方形基板的新平臺。另外,針對在大型方形基板上容易發生的基板翹曲的問題,通過搭載新的搬送系統,可在矯正10mm大翹曲的狀態下進行曝光。因此,新產品實現了高效生產大型半導體芯片的PLP工藝,可應對要求高產能的用戶需求。
■ 實現1.0微米的解像力,對應高端封裝
佳能自主研發的投影光學系統可實現52×68mm的大視場曝光,達到了方形基板封裝光刻機中高標準的1.0微米解像力。因此,實現了應對半導體芯片的高集成化、薄型化需求的PLP等高端封裝工藝,且可滿足各種用戶需求。
<參考>
■ 什么是半導體光刻機的后道工序
在半導體器件的制造過程中,半導體光刻機起到“曝光”電路圖案的作用。通過一系列的曝光,在硅片上制造半導體芯片的過程稱為前道工序;保護精密的半導體芯片不受外部環境的影響,并在安裝時實現與外部電氣連接的封裝過程稱為后道工序。
■ 什么是PLP
PLP是Panel Level Packaging的縮寫,是指將多個半導體芯片排列在一個薄型方形大尺寸面板上并一次成型模制的封裝制造方法。與普通的300mm晶圓相比,可以一次性高效地將許多半導體芯片放置在晶圓上,從而實現高產能。
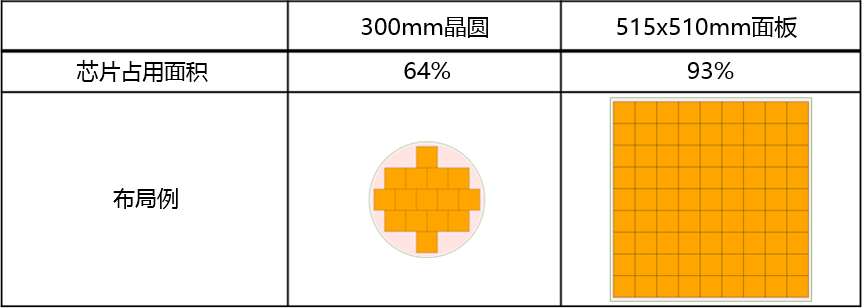
<半導體光刻機的市場動向>
隨著近幾年物聯網的發展,在半導體器件制造中,封裝基板變得越來越集成化,也越來越薄。例如,由于高性能CPU或FPGA連接到多個高速大容量存儲器,因此用于數據中心的高性能AI芯片的封裝,有集成化和大型化的發展趨勢。作為先進的封裝技術之一,PLP不僅支持半導體器件的高度集成和薄型化,而且還通過大型基板的應用實現了高產能,作為一種前景明朗的技術而備受關注。PLP通常用于制造追求高速處理的尖端半導體器件,例如AI芯片、HPC6等。(佳能調研)
本網站及其公眾號為公益性網絡平臺,所發圖文僅供傳播信息、介紹知識、說明問題之用;相關版權歸原作者所有,轉載請務必注明出處和作者。
稿件一經選用,即視為作者同意本網免費將其使用于本網或與本網有合作關系的非贏利性各類出版物、互聯網與手機端媒體及專業學術文庫等。
由稿件引起的著作權問題及其法律責任由作者自行承擔。
了解更多動態,請掃描二維碼,關注我們的微信公眾號:
